Bonding CLA
Responsibility:

- Wedge bonding of 25 µm Gold wires
- Deep access tool for bonding in packages
- Semiautomatic bonding process (Y- and Z-Axis motorized)
- Heated workholder with vacuum chuck (diameter 80 mm2) for clamping substrates
- Bonder and work place ESD (Electro Static Discharge) save for sensitive applications
- Ionizer (fan) for neutralize static charges on surfaces / devices
Responsibility:
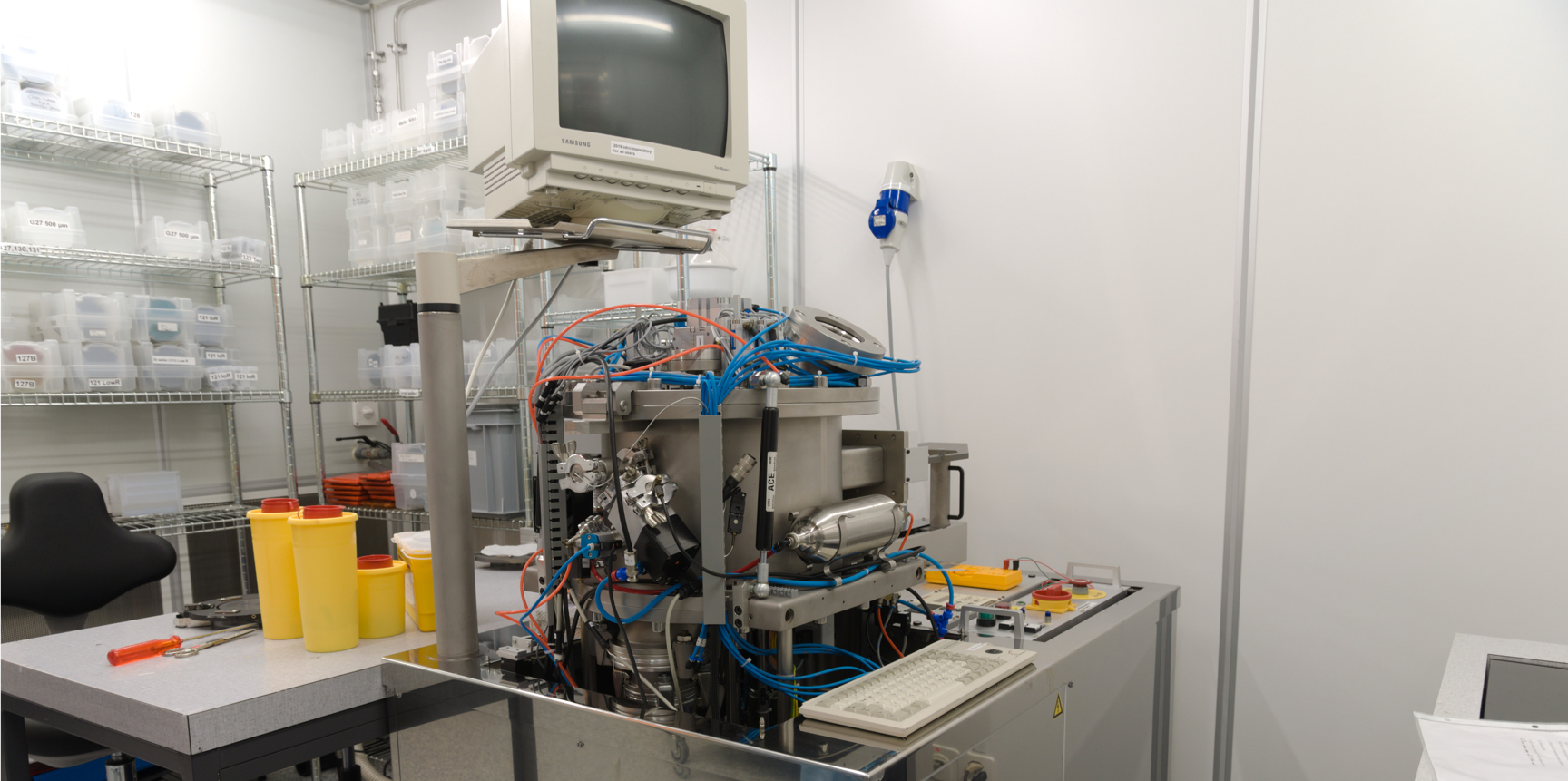
- Thermocompression, anodic, eutectic and adhesive wafer bonding possible for up to 3'' wafers and smaller pieces (down to ~10x10 mm2)
- Up to 20 kN force for full wafers (maximum force scales with sample size)
- Heatable bottom plate, maximum temperature 500 °C, programmable temperature ramps, temp. uniformity +/- 2%
- N2 purge/cooling gas
- Chamber pressure control during bonding from atmospheric down to 5*10-5 mbar (turbo pump)
- SiC clamping plate for homogeneous force and temperature distribution
- Automatic operation (recipes) with live plots of process parameters