Bonding
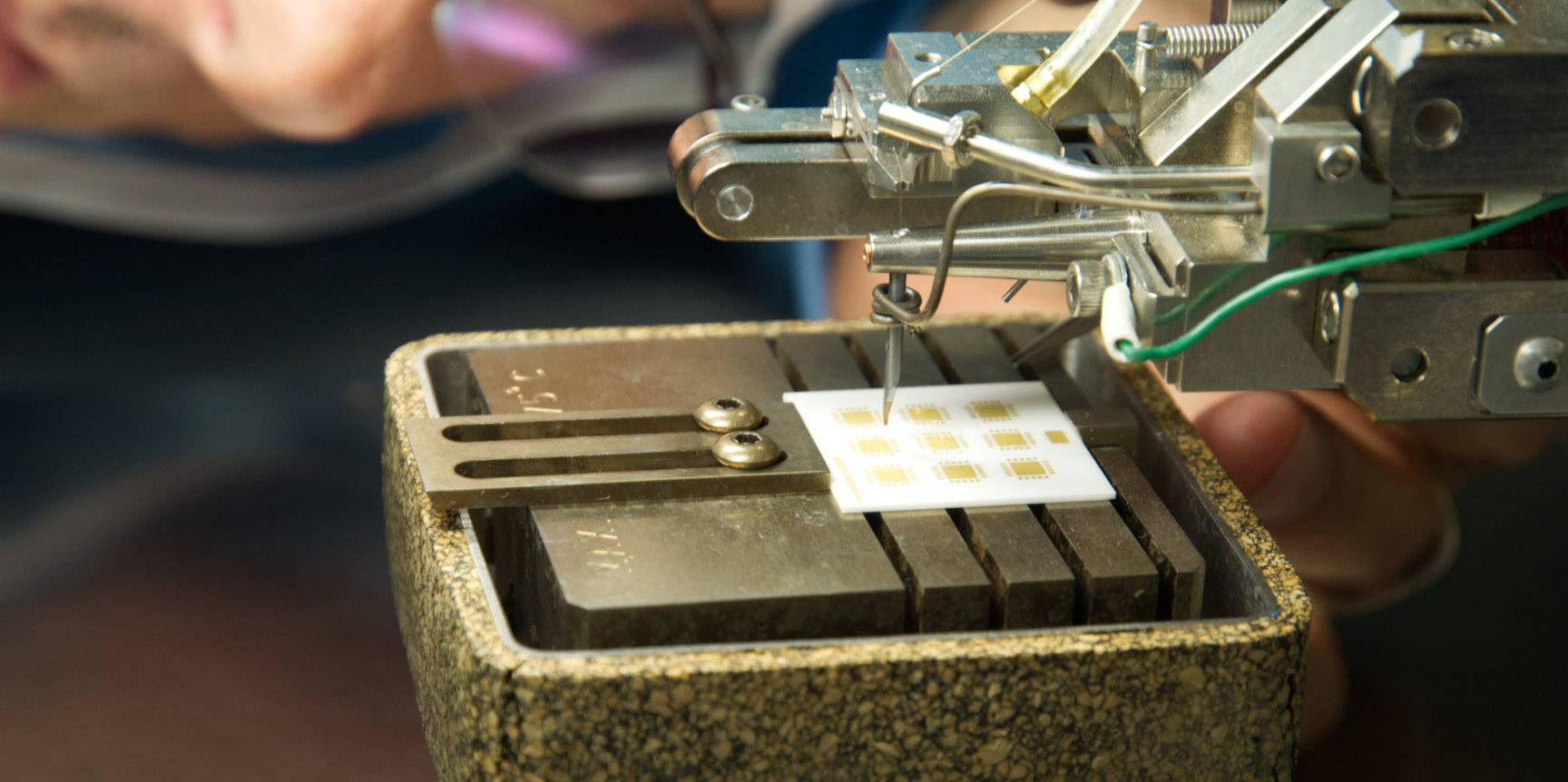
Wire bonder creating an electrical contact on chip level.
Responsibility:

- Wire wedge bonding of 25 mue Gold wires
- Deep access tool for bonding in packages
- Part size up to 200 x 200 mm2
- Ribbon bonding tools for HF-applications (Option on request)
- Heated workholder (2") for clamping plates and DIL-packages
- Bonder and work place ESD (Electro Static Discharge) save for sensitive applications
- Ionizer (fan) for neutralize static charges on surfaces / devices
Responsibility:
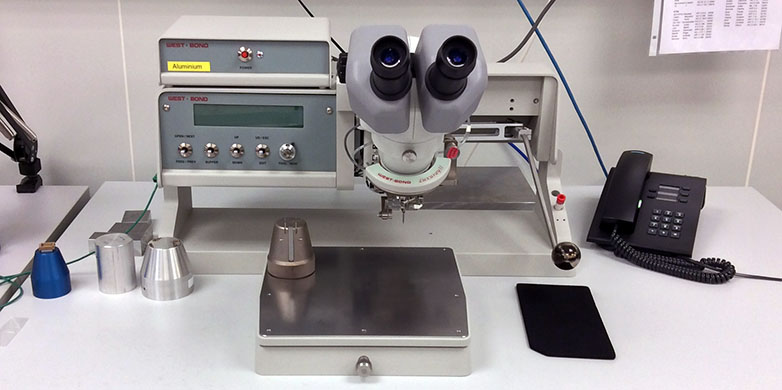
- Wedge bonding of 25 mue Aluminium wires
- Deep access tool for bonding in packages
- Part size up to 200 x 200 mm2
- Heated workholder (50 x 50 mm2) for clamping plates and DIL-packages
- Bonder and work place ESD (Electro Static Discharge) save for sensitive applications
- Ionizer (fan) for neutralize static charges on surfaces / devices
Responsibility:
- Kieran Dalton
- N.N.

- Fully automatic bonding with manual part feeding
- Travel distances 100 x 100 mm
- Two bonding heads:
- 5630i for Au wire
Thin Wire Wedge-Wedge - 5632i for Al wire
Thin Wire Deep Access Wedge-Wedge
- 5630i for Au wire
Note:
Due to the configuration required, this tool is only recommended for large bonding jobs, or those requiring precise bond placement. Manual bonders are more useful for smaller jobs (<100 bonds).
Responsibility:

- Thermocompression, anodic, eutectic and adhesive wafer bonding possible for up to 3'' wafers and smaller pieces (down to ~10x10 mm2)
- Up to 20 kN force for full wafers (maximum force scales with sample size)
- Maximum temperature 500 °C, programmable temperature ramps, temp. uniformity +/- 2%
- N2 purge/cooling gas
- Chamber pressure control during bonding from atmospheric down to 5*10-5mbar (turbo pump)
- SiC clamping plate for homogeneous force and temperature distribution
- Automatic operation (recipes) with live plots of process parameters