Electron-Beam Lithography (EBL)
FIRST operates two electron beam lithography systems from Raith GmbH. Both systems operate at beam energies up to 30 keV and can handle any shaped substrates up to 6” in diameter.
Responsibility:
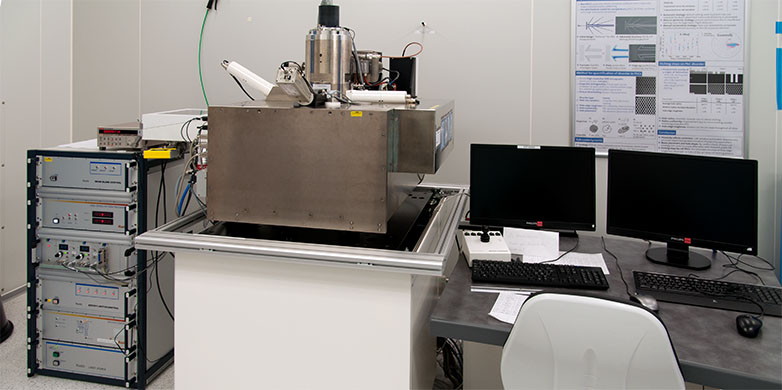
Raith 150
- Schottky thermal-field emission filament, resolution: 2 nm @ 20 kV
- Acceleration voltage: 200 V – 30 kV
- Beam current: 4 pA – 350 pA
- Working distance: 2 – 12 mm
- Writefield: 1 μm – 1 mm
- 16 bits / 10 MHz pattern generator
- Samples: 1 mm – 6”
- Interferometer stage, 2 nm positioning accuracy
- Overlay and stitching accuracy: better than 20nm
- High degree of automation for automatic pattern placement and long exposures

Raith 150TWO
- Schottky TFE electron beam source
- Dose stability for any time period
- In-Lens SE detector for shadow free metrology
- Laser height sensor for automatic focus setting
- Digital 20 MHz Pattern Generator
- Laser interferometer with 1 nm resolution
- Small samples up to 8" wafers compatible
- Beam size < 2 nm @ EHT > 20kV
- Beam position stability ≤ 200 nm in 8 hours
- Beam current stability ≤ 0.5% in 8 hours
- Minimum feature size < 10 nm
- 200-μm field stitching < 40 nm accuracy
- 200-μm field overlay < 40 nm accuracy
- High degree of automation for automatic pattern placement and long exposures